
作者:李阳、赵铭
摘要
■ 投资逻辑
先进封装+HBM拉动封装材料产业链量价齐升
先进封装+存储需求拉动下,我们看好半导体封装材料产业链将迎来量价齐升,例如海力士将其HBM4产品供应给英伟达,比其前代HBM产品单价高出50%以上。本文梳理存储封装材料包括:①环氧塑封料,②硅微粉,③载板上游:Low-CTE电子布/载体铜箔。
环氧塑封料:国产化率低,期待产品结构迭代、单位价值量跃升
环氧塑封料(EMC)属于半导体封装材料里的包封材料,随着先进IC封装技术的不断发展,对EMC材料的综合性能提出越来越高的要求。国产化率低、估计高性能EMC国产化率仅10-20%,先进封装国产化率更低,海外主要竞争对手包括住友电木、力森诺科等,国内企业有望重塑EMC行业竞争格局。
随着国内封测向先进封装迭代,环氧塑封料存在产品结构迭代、单位价值量跃升的逻辑,例如应用于先进封装FOWLP/FOPLP的环氧塑封料需以颗粒状(GMC)的形态呈现,对环氧塑封料的性能提出更高要求。参考衡所华威数据,先进封装EMC单价是高性能EMC的5-6倍、是基础EMC价格的10倍以上。以存储为例,随着SK海力士从DRAM向HBM迭代,其HBM采用MR-MUF技术、在半导体芯片缝隙中注入液体EMC。
硅微粉:环氧塑封料关键原材料
环氧塑封料主要原材料为硅微粉、环氧树脂、酚醛树脂、添加等,其他辅料材料包括包材、备件等,其中无机填料起到有效降低环氧塑封料热膨胀系数的作用。参考华海诚科收购标的衡所华威数据,2023-2024年其第一大供应商均为联瑞新材(采购硅微粉及添加剂),2024年硅微粉、添加剂分别占衡所华威原材料采购金额的比重为29%、26%。
Low-α球铝可以很好解决在存储领域高密度叠层封装所遇到的问题,联瑞新材Low-α球铝系列产品放射性元素铀(U)和钍(Th)含量均低于 5ppb 级别,最低可低于 1ppb级别,已稳定批量配套行业领先客户。
载板上游:Low-CTE电子布/载体铜箔
封装基板与PCB制造原理相近,具有高密度、高精度、高性能、小型化及薄型化等特点,是芯片封装不可或缺的一部分,为主要应用于移动智能终端、服务器/存储等领域。
(1)Low-CTE电子布:终端主要应用场景包括存储、FC-BGA、5G高频通信等领域,目前已成为载板环节重要供给瓶颈。根据中国台湾工商时报消息,日商三菱化学发出通知,因Low-CTE玻纤布原料短缺、以及订单需求增加,导致其BT载板材料交期大幅拉长,部分Low-CTE玻纤布交期达16-20周。
(2)载体铜箔:主要应用于IC载板、类载板,当前带载体可剥离超薄铜箔的全球市场规模约50亿元,多年来基本被日本三井金属垄断。随着AI技术发展,对先进芯片需求(例如SLP)不断增加,将推动载体铜箔市场持续增长,日本企业扩产节奏及意愿偏弱,叠加国内供应链加速本地化,利于载体铜箔国产替代进程。
风险提示
国产替代不及预期;进入海外供应链节奏不及预期;行业竞争格局恶化。
+
目录
1、先进封装+HBM拉动封装材料产业链量价齐升
1.1 环氧塑封料
1.2 硅微粉
1.3 IC载板上游原材料——Low-CTE电子布/载体铜箔
2、存储封装材料行业标的梳理
2.1 环氧塑封料:华海诚科
2.2 硅微粉:联瑞新材
2.3 Low-CTE电子布:中材科技、宏和科技
2.4 载体铜箔:铜冠铜箔、方邦股份
2.5 HBM检测设备:赛腾股份
风险提示
正文
1 、先进封装+HBM拉动封装材料产业链量价齐升
先进封装+存储需求拉动下,我们看好半导体封装材料产业链将迎来量价齐升。随着集成电路制程工艺已接近物理尺寸极限,“后摩尔时代”集成电路通过先进封装技术提升芯片整体性能已成为趋势,先进封装技术已成为延续摩尔定律的最佳选择之一,预计在封装市场的占比将逐步提升。
根据韩国Business Korea报道,SK海力士将其HBM4产品供应给英伟达,比其前代HBM产品单价高出50%以上。HBM4将用于英伟达下一代AI芯片Rubin,预计将于26H2问世。HBM4拥有2048条数据传输通道(I/O),是HBM3E的2倍(1024条),此外HBM4还在GPU与HBM的基片中集成了“逻辑工艺”,如计算效率和能源管理功能。

半导体封装材料包括引线框架、芯片粘结材料、键合金丝、包封材料、缝合剂、其他封装材料等。
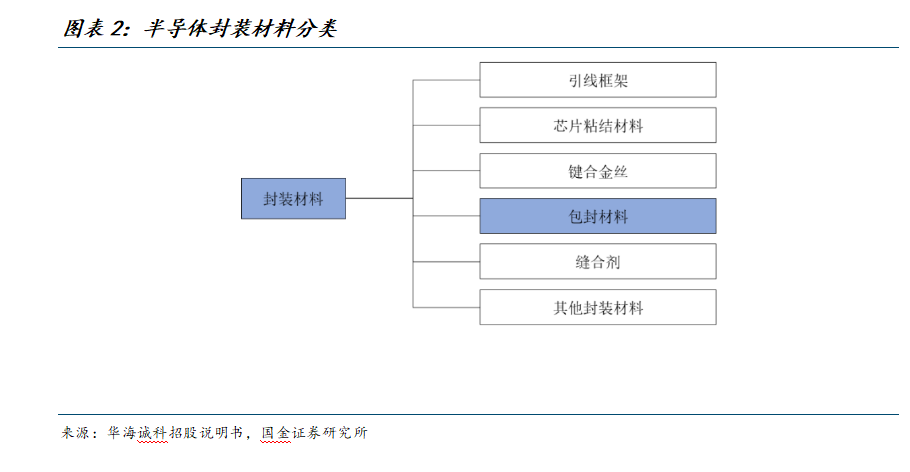
1.1 环氧塑封料
环氧塑封料属于半导体封装材料里的包封材料。根据封装材料的不同,电子封装分为塑料封装、陶瓷封装和金属封装3种:
陶瓷封装和金属封装为气密性封装,由于其工艺复杂、成本高,主要用于航空航天领域;
塑料封装由于其成本低廉、工艺简单、并适合于大批量生产,目前在全世界范围内占集成电路市场的95%以上,封装形式包括DIP、SOP、BGA、CSP等类型。
环氧塑封料(EMC),全称为环氧树脂模塑料,用于半导体封装的一种热固性材料,以环氧树脂为基体树脂,以高性能酚醛树脂为固化剂,加入硅微粉等填料,以及添加多种助剂加工而成,主要功能为保护半导体芯片不受外界环境(水汽、温度、污染等)的影响,并实现导热、绝缘、耐湿、耐压、支撑等复合功能。
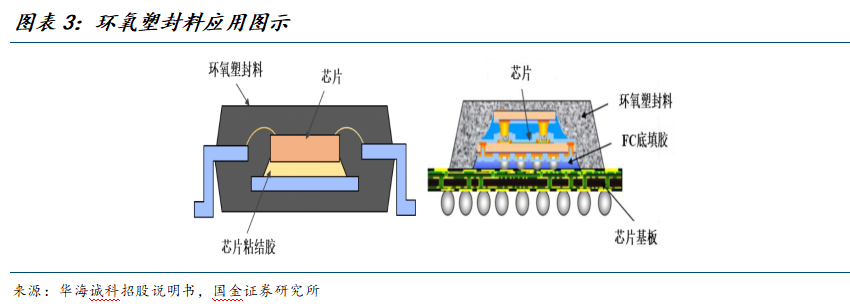
随着先进IC封装技术的不断发展,对EMC材料的综合性能提出越来越高的要求:
(1)高耐热与低熔体黏度,随着汽车和电子等特种芯片产品的快速发展以及高熔点无铅焊料的广泛使用,EMC发展趋势为进一步提高耐温等级和高温尺寸稳定性;
(2)高导热与高绝缘,随着IC芯片向高速高集成化和微型化方向发展,芯片工作时的放热问题越来越突出,EMC作为芯片的导热通道、需要具有更高热导率,方法有加入高导热填料,以及应用具有本征高导热特性的特种环氧树脂与酚醛固化剂;
(3)低翘曲与高熔体流动性,为,适应大尺寸模塑封装工艺,需要EMC固化物具有尽可能低的翘曲率,同时在模塑过程中保持优良的熔体流动性,方法为提升现有EMC中的球型硅微粉含量(质量分数≥90%);
(4)低介电常数与介电损耗,为实现脉冲信号传递的高速化,要求所使用的介质材料应具有尽可能低的介电常数Dk和介电损耗Df,方法为应用含有脂环单元的特种环氧树脂;
(5)适应大尺寸器件封装成型工艺。EMC目前主要是采用传递模塑工艺进行IC芯片封装,因此产品类型主要以固体柱状为主。后续为适应大尺寸模塑封装工艺、如板级FOWLP封装应用需求,需要采用压缩型模塑工艺,相应EMC也需由传统的固体柱状产品向固体颗粒状/液态形式发展。

国产化率低、估计高性能EMC国产化率仅10-20%,先进封装国产化率更低,海外主要竞争对手包括住友电木、力森诺科等,国内企业有望重塑EMC行业竞争格局。根据共研咨询数据,2025年我国半导体用环氧塑封料产量为23.24万吨,国内主流环氧塑封料企业包括:
华海诚科,2024年环氧塑封料销售量为1.19万吨,同时收购国内另一家环氧塑封料企业衡所华威(目前已收购30%股权,同时通过发行股份等方式收购剩余70%股权、尚处于落地阶段),收购落地后环氧塑封料年产销量有望超2.5万吨,稳居国内龙头地位,跃居全球出货量第二位;
飞凯材料(维权)子公司兴凯半导体,环氧塑封料前期优先保障在功率器件、电源分立适配、家电及光伏等成熟应用领域的市场份额,今年正投资建设一条专用于先进封装的高性能EMC产线。

随着国内封测向先进封装迭代,环氧塑封料存在产品结构迭代、单位价值量跃升的逻辑。先进封装类环氧塑封料相较传统封装类更高端,应用 FOWLP/FOPLP的环氧塑封料需以颗粒状(GMC)的形态呈现,对环氧塑封料的导热性、吸水率、应力、粘接力、可靠性等性能提出了更高要求。参考华海诚科收购标的衡所华威数据,先进封装EMC单价是高性能EMC的5-6倍、是基础EMC价格的10倍以上。
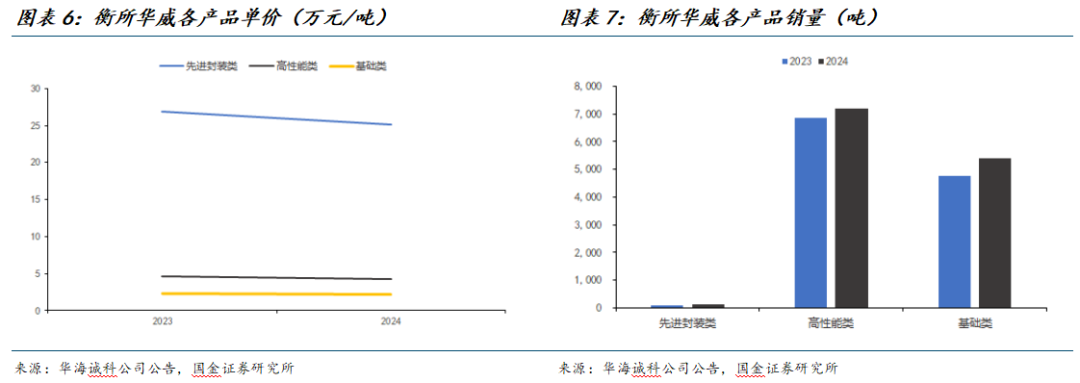
以存储为例,随着SK海力士从DRAM向HBM迭代,其HBM技术是大规模回流成型底部填充(MR-MUF)技术,将半导体芯片堆叠,在其缝隙中注入液体EMC(LEMC),并固化以保护芯片间电路。LEMC具有可中低温固化、低翘曲、模塑过程无粉尘、低吸水率及高可靠性等优点,是目前用 WLCSP技术的主要塑封材料,在WLCSP技术以及HBM产品中得到广泛应用。
先进封装技术对MR-MUF型LEMC的性能需求主要体现在:
适宜的工艺黏度以保障在封装工艺操作过程中具有出色的流动性。由于填料含量高,LEMC 在施胶过程中具有很高的黏度,需采用特定的点胶技术、以使流体能集成在全自动压缩成型机中。LEMC的黏度值一般不超过1000Pa·s,随着填料含量增加,其热膨胀系数(CTE)降低,而黏度增加。因此在成型过程中,需使用平衡良好的材料,使黏度低于1000Pa·s的临界值;
成型温度下优良的流动性以实现窄间距(≤20μm)的填充。LEMC在成型过程中,良好的流动性可减少封装成型过程中填料堵塞造成的流痕等不良现象,尤其是在芯片与压缩机模具间距较小时;
良好的低温(≤100℃)固化性;
固化物具有低CTE和低热阻(高热导率),以防止封装体由于热应力而产生翘曲等。玻璃化转变温度Tg以下的CTE目标值应小于1×10-5K-1,而热阻值则尽可能低。
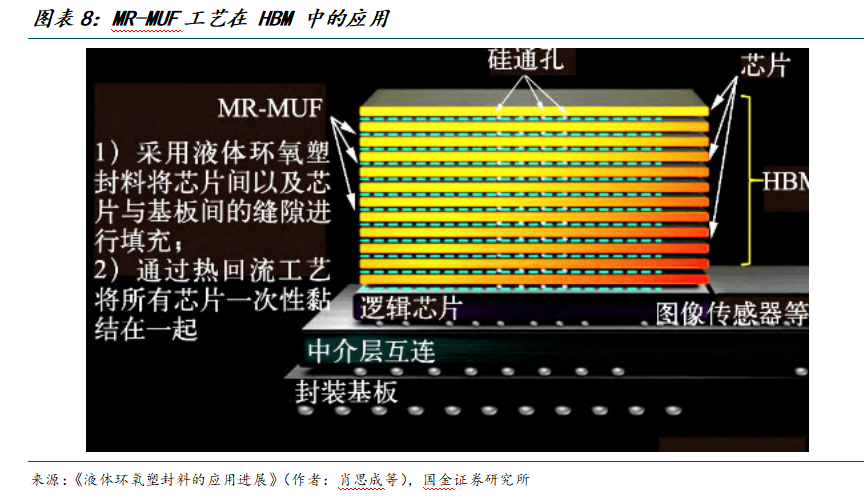
1.2 硅微粉
环氧塑封料主要原材料为硅微粉、环氧树脂、酚醛树脂、添加剂(包括催化剂、偶联剂、脱模剂、着色剂等助剂)等,其他辅料材料包括包材、备件等。
构成半导体集成电路器件的材料包括硅芯片、表面钝化膜、引线框架等,以上材料与环氧塑封料的热膨胀系数相差很大。加热固化时,因热膨胀系数差异而使器件内部产生热应力。应力的存在会导致几个方面的不良后果:①塑封料开裂,②表面钝化膜开裂,铝布线滑动,电性能变坏,③界面处形成裂缝,耐湿性变差,④封装器件翘曲。影响热应力大小的因素有弹性模量E、玻璃化转变温度、热膨胀系数,因此降低内应力一直是环氧塑封料行业中的关键问题。环氧树脂的热膨胀系数大约为6.0x10-5,而二氧化硅的热膨胀系数是 6.0x10-7,两者相差 100 倍,使用无机填料可以有效地降低环氧塑封料的热膨胀系数。
参考华海诚科收购标的衡所华威数据,2023-2024年其第一大供应商均为联瑞新材(采购硅微粉及添加剂),2024年硅微粉、添加剂分别占衡所华威原材料采购金额的比重为29%、26%。


1.3 IC载板上游原材料——Low-CTE电子布/载体铜箔
封装基板与PCB制造原理相近,具有高密度、高精度、高性能、小型化及薄型化等特点,是芯片封装不可或缺的一部分,为芯片提供支撑、散热和保护作用,同时也为芯片与PCB母板之间提供电气连接。以深南电路为例,其生产的封装基板产品主要应用于移动智能终端、服务器/存储等领域。
(1)Low-CTE电子布
Low-CTE,通信产品、消费电子等对于内部芯片集成度与算力速度提升,芯片的尺寸由小变大,在PCB组装焊接时会发生焊点开裂等问题,采用Low CTE材料可降低热应力、提高焊点可靠性。目前终端主要应用场景包括存储、FC-BGA、5G高频通信等领域。
目前Low-CTE电子布已成为载板环节重要供给瓶颈。根据中国台湾工商时报消息,日商三菱化学发出通知,因Low-CTE玻纤布原料短缺、以及订单需求增加,导致其BT载板材料交期大幅拉长,目前部分Low-CTE玻纤布交期达16-20周。
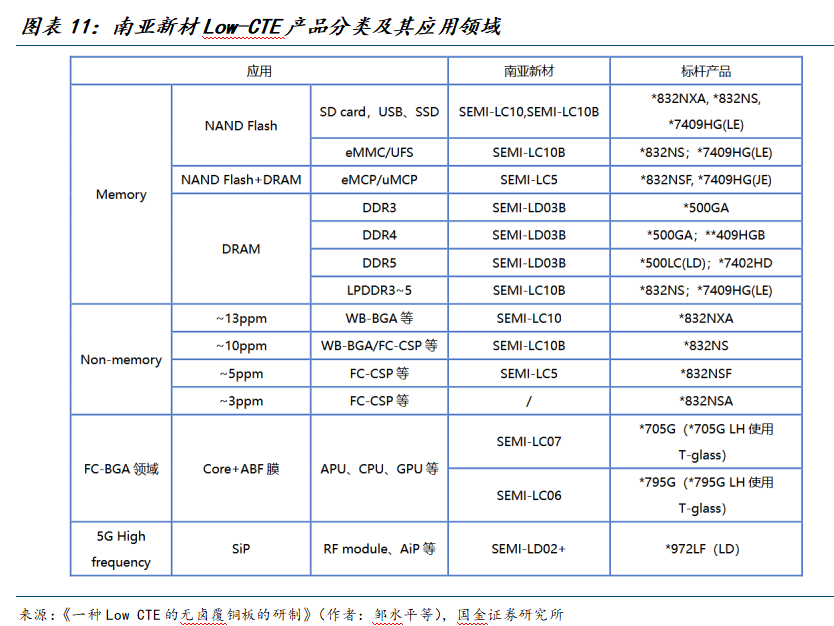
(2)载体铜箔
极薄铜箔(亦称载体铜箔/可剥离铜箔),一般指厚度在9um及以下的PCB铜箔,极薄铜箔HDI基板主要为微细线路基板(高阶产品应用主要为手机与通讯类)、IC封装基板、类载板(SLP)、模块基板等产品领域。为极薄铜箔在PCB加工中便于操作,以及保证基材(一般为半固化片/树脂膜)成形加工的质量,在极薄铜箔制造过程中,在极薄铜的光面(即S面)一侧附上与介质基材有一定接合力的载体(大都用铜箔材,也有采用铝材),因此构成的电解铜箔亦称为附载体极薄铜箔。
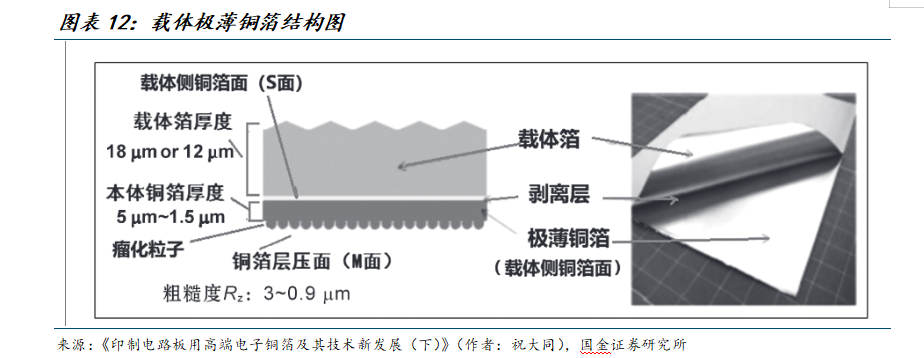
带载体可剥离超薄铜箔,具有厚度极薄、表面轮廓极低、载体层和可剥离层之间的剥离力稳定可控等特性,是制备芯片封装基板、HDI 板的必需基材。目前IC载板、类载板的线宽线距已细至10/10-40/40um,传统减成法制程工艺无法制备,主要使用mSAP(半加成工艺),而mSAP必须使用载体铜箔。
SLP拉动载体铜箔需求。SLP类载板,是指具有接近于IC载板特征尺寸的PCB,主要特征是线宽和线距(L/S)尺寸界于常规PCB和IC载板之间,传统PCB以及HDI板的线宽和线距尺寸大于30/30 um,而IC载板的线宽和线距通常小至15/15 um。SLP制造工艺采用mSAP,mSAP从薄的层压铜箔(1.5-5.0um)开始,以薄铜为种子层、进行图形电镀与闪蚀。根据Global Technology Research数据,SLP应用领域包括:①智能手机,2017年iPhone要求PCB密度类似于封装载板,产生SLP需求、带动mSAP工艺发展。2018 年初,三星Galaxy手机也采用SLP设计;②今年起,800G/1.6T光模块制造商也开始采用SLP设计。

根据方邦股份投资者交流数据,当前带载体可剥离超薄铜箔的全球市场规模约50亿元,多年来基本被日本三井金属垄断。随着AI技术发展,对先进芯片需求(例如SLP)不断增加,将推动载体铜箔市场持续增长,日本企业扩产节奏及意愿偏弱,叠加国内供应链加速本地化,利于载体铜箔国产替代进程。
2、存储封装材料行业标的梳理
2.1 环氧塑封料:华海诚科
公司头部客户均为国内知名半导体封测企业,例如2021年公司前五大客户包括华天、长电、扬杰科技、银河微电等。根据公司招股说明书确认,2021年公司为长电科技、华天科技、气派科技、银河微电、晶导微、虹扬科技、四川利普芯、重庆平伟等国内半导体封装厂商的第一大内资供应商。

2024年11月,公司公告拟购买衡所华威100%股权,其中70%股权交易价格定为11.2亿元,现金支付3.2亿元、股份支付3.2亿元(股份发行价格为56.15元/股,发行数量为570万股、占发行后总股本的6.60%)、可转债支付4.8亿元(初始转股价格为56.15元/股,存续期限4年)。2025年9月发行股份及支付现金购买衡所华威已得到证监会批复,10月衡所华威70%已实现过户。
本次交易实施前,华海诚科以及衡所华威分居半导体环氧塑封料国内厂商出货量第二位、第一位,2024年华海诚科环氧塑封料销量1.19万吨、整体收入3.32亿元,衡所华威环氧塑封料销量1.28万吨、整体收入4.68亿元。待交易成功实施后,上市公司在半导体环氧塑封料领域的年产销量有望突破 2.5万吨,稳居国内龙头地位,跃居全球出货量第二位。

2.2 硅微粉:联瑞新材
Low-α球形氧化铝可以很好解决在存储领域高密度叠层封装所遇到的问题,联瑞新材Low-α球形氧化铝系列产品放射性元素铀(U)和钍(Th)含量均低于 5ppb 级别,最低可低于 1ppb级别,已稳定批量配套行业领先客户。
2.3 Low-CTE电子布:中材科技、宏和科技
国内主要Low-CTE电子布厂商包括中材科技、宏和科技等。
(1)中材科技,定增保障特种玻纤项目资金落地,公司是特种玻纤“大满贯”,扩产加速、继续提升市占率:
25H1特种纤维布实现销售895万米,产品覆盖低介电一代、低介电二代、低膨胀布及超低损耗低介电布全品类产品,均完成国内外头部客户的认证及批量供货;
低膨胀布打破国外垄断局面,成为国内唯一、全球第二家能够规模化生产低膨胀布产品的供应商;
超低损耗低介电布率先完成行业头部CCL厂商客户认证,实现市场导入及产业化供应。若扩产推进顺利,公司有望先行渗透核心终端供应链,以市占提升带动盈利上行。
(2)宏和科技:公司不断自主研发多种高端极薄布、超薄布、极细纱、超细纱,并成功研发出低介电、低热膨胀系数等高性能电子级玻璃纤维产品,使公司成为国内极少数能提供该类产品的厂商之一,成功打破国际垄断。
2.4 载体铜箔:铜冠铜箔、方邦股份
国内主要载体铜箔厂商包括铜冠铜箔、方邦股份等。
(1)铜冠铜箔:截至25H1期末,公司RTF铜箔产销能力于内资企业中排名首位,HVLP1-3铜箔报告期内已向客户批量供货、产量同比持续增长,HVLP4铜箔正在下游终端客户全性能测试,载体铜箔已掌握核心技术,正在准备产品化、产业化工作。
(2)方邦股份:公司带载体可剥离超薄铜箔主要应用于IC载板和类载板截至目前,该产品相关型号陆续通过了多家下游客户的测试认证,持续获得小批量订单,并在与客户、终端的应用沟通反馈过程中持续提升产品品质和良率,逐步突破“从0到1”的最艰难阶段,未来 1-2年内订单起量有望加快。
2.5 HBM检测设备:赛腾股份
赛腾股份:通过并购进入晶圆检测及量测设备领域并取得显著成效,成为 Sumco、samsung、协鑫、奕斯伟、中环半导体等境内外知名品圆厂商的设备供应商。收购完成后公司高效整合技术,持续拓展高端半导体领域设备产品线,在 HBM 等新兴领域实现应用突破。
风险提示
国产替代不及预期:以上材料我们预计国产化率偏低,例如高性能EMC国产化率仅10-20%,硅微粉/Low-CTE电子布/载体铜箔等同理。国产化率低的背景下,我们预计国内主流存储企业有较强诉求推进材料端国产替代,但仍存在替代节奏不及预期。
进入海外供应链节奏不及预期:目前全球存储市场龙头企业仍然为外资三星、海力士、美光等,如果以上新材料进入海外供应链的节奏偏慢,可能导致部分高端产品放量节奏不及预期。
行业竞争格局恶化:目前以上新材料竞争格局较好,但后续如果有更多中国企业切入环氧塑封料领域,可能会导致行业竞争格局恶化,甚至出现价格下滑风险。
阅读全文
《非金属建材行业研究: 存储上行,封装材料,厚积薄发》 ]article_adlist-->+
报告信息
证券研究报告:《非金属建材行业研究:存储上行,封装材料,厚积薄发》
报告日期:2025年11月16日
作者:
李阳 SAC执业编号:S1130524120003
赵铭 SAC执业编号:S1130524120004
 ]article_adlist-->
]article_adlist-->
 ]article_adlist-->
]article_adlist-->
 海量资讯、精准解读,尽在新浪财经APP
海量资讯、精准解读,尽在新浪财经APP
淘配网平台提示:文章来自网络,不代表本站观点。







